Description
Fine interconnections
The protruding electrodes on a silicon chip or substrate are called “bumps”. It is possible to form bumps with a diameter of 30 μm from ultrafine wires with a diameter of 15 μm. Since the tip shape of the bump can be processed, this technology can be used in many areas.
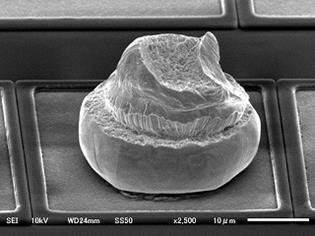
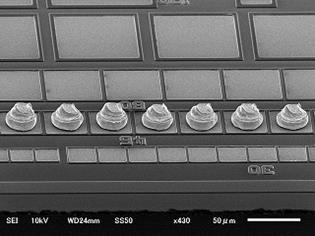
15-µm wire into 30-µm bump
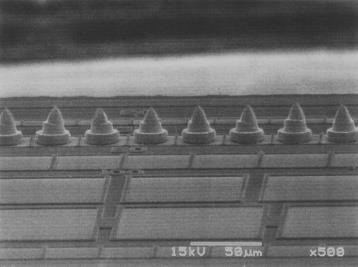
Stud bump
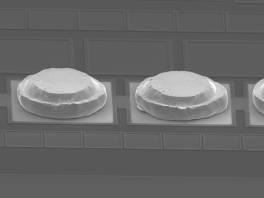
Leveling bump
Flexible wiring
Kaijo has a variety of fine wiring technologies cultivated in wire bonders.
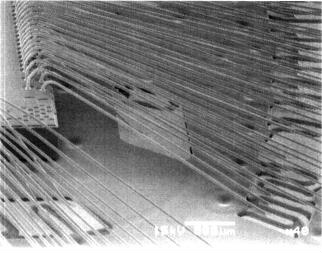
Alternate wiring

High stepped

Overhung chip

Chained loop


Flexible wiring and high repeatability
Differently shaped electrodes
With Kaijo’s unique technology and experience cultivated for many years, ultra-fine wires can be formed into various shapes for different applications. We support wire materials such as Au, Ag, Cu and Pt.

Using the loop as a contact
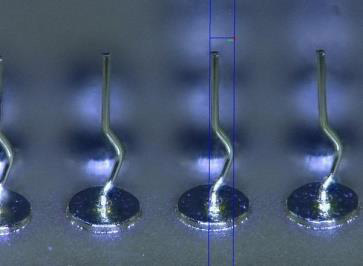
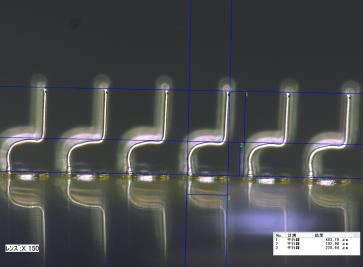
Contact with spring functionality due to bending of wire
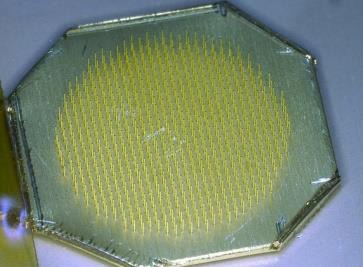
Example of Au electrode
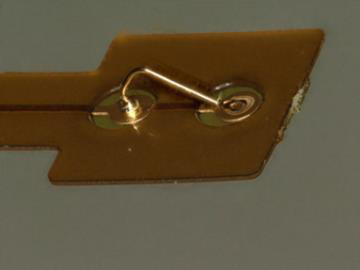
Coated wire bonding
Kaijo have bonding know-how for wires coated with polyurethane and polyester. This drastically reduces manual soldering and both saves labor costs and drives automation.
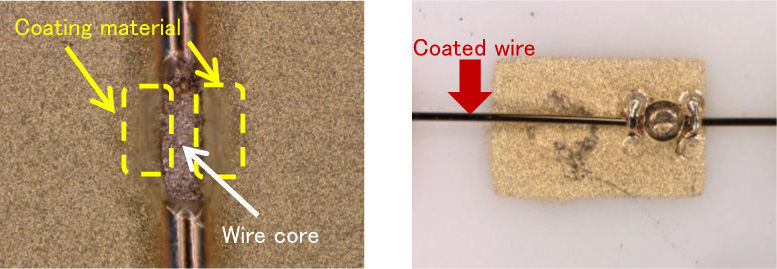
A patent has been applied for a technology that removes the coating by ultrasound and splices wires.
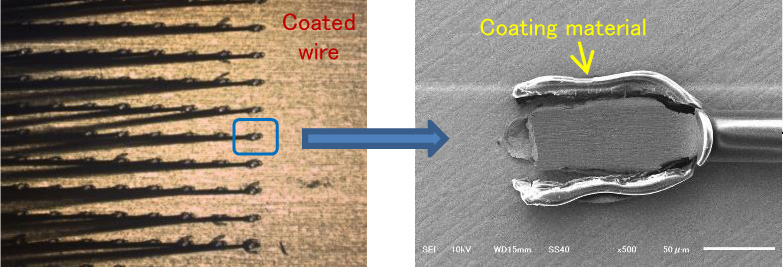
A metal bonding tool breaks the coating using ultrasound. At the same time, electric current is conducted into the wire via the tool to heat and bond it instantly.

